Технология получения полупроводниковых подложек кремния
ВВЕДЕНИЕ
полупроводниковый подложка транзистор
В данной курсовой работе будет рассмотрен полупроводниковый материал -
кремний, описаны его физические, химические и электрофизические характеристики,
и приведен технологический алгоритм получения подложек кремния. Данная работа
имеет большую актуальность, так как кремний является ведущим материалом для
производства полупроводниковых приборов. Причиной этому множество достоинств
данного материала:
. Кремний второй по распространенности на земле элемент после кислорода:
содержание кремния в земной коре составляет 27,6% по массе, поэтому кремний -
один из самых дешевых материалов для производства полупроводниковых подложек,
[1].
. Кремний является самым чистым материалом. Содержание примесей в
доочищенном кремнии может быть снижено до 10−8-10−6
% по массе.
. Кремний образует естественную защитную пленку - оксид кремния SiO2, которая защищает от воздействия внешней агрессивной
среды и может быть использована как изолятор, и, что очень важно, в качестве
маски, в технологических процессах производства микросхем на подложках кремния,
[2].
. Ширина запрещенной зоны кремния 1,12 эВ (при 3000К),
что позволяет кремниевым диодам могут работать при температуре вплоть до 200 ºС, [3].
. Кремний характеризуется меньшей диэлектрической проницаемостью,
по сравнению с другими полупроводниками, что обусловливает меньшие значения
барьерных емкостей переходов при той же их площади и позволяет увеличить
быстродействие ИМС.
. Кремний нетоксичен в большинстве своих химических соединений, и
его производство не сопровождается получением настолько загрязняющих окружающую
среду отходов, несопоставимых с масштабами металлургических и химических
производств.
Благодаря всем этим уникальным свойствам кремний применяется в очень
широком спектре производств. (silicium) - химический элемент 4A подгруппы
периодической системы элементов, неметалл. Встречается в природе в основном в
виде песка, или кремнезема, который представляет собой диоксид кремния, и в
виде силикатов. Концентрация в морской воде 3 мг/л. Чаще всего в природе
кремний встречается в виде кремнезёма - соединений на основе диоксида кремния
SiO2 (около 12 % массы земной коры). Элементарный кремний в
монокристаллической форме является непрямозонным полупроводником. В чистом виде
он был впервые выделен в 1811 году французскими учёными Жозефом Луи
Гей-Люссаком и Луи Жаком Тенаром. В 1825 году шведский химик Йёнс Якоб
Берцелиус действием металлического калия на фтористый кремний SiF4
получил чистый элементарный кремний. Новому элементу было дано название
«силиций» (от лат. silex -кремень).
Русское название «кремний» введено в 1834 году российским химиком Германом
Ивановичем Гессом.
В данной курсовой работе мы рассматриваем кремний в первую очередь как
материал для производства полупроводниковых подложек.
Подложка в микроэлектронике - это обычно монокристаллическая
полупроводниковая пластина, предназначенная для создания на ней плёнок,
гетероструктур и выращивания монокристаллических слоёв с помощью процесса
эпитаксии кристаллизации и т. д. В их объеме и на поверхности методами
травления, окисления, диффузии, эпитаксии, имплантации, фотолитографии, другими
технологическими приемами формируются элементы микросхем электронных приборов и
устройств.
Качество поверхности подложки определяется ее микрорельефом
(шероховатостью), кристаллическим совершенством поверхностных слоев и степенью
их физико-химической чистоты. Поверхность подложки характеризуется
неплоскостностью и непараллельностью. Высокие требования предъявляются и к
обратной - нерабочей стороне подложки. Неодинаковая и неравноценная обработка
обеих сторон подложки приводит к дополнительным остаточным механическим
напряжениям и деформации кристалла, что обусловливает изгиб пластин. В процессе
обработки и подготовки поверхности подложек полупроводников необходимо создание
совершенных поверхностей, имеющих высокую степень плоскопараллельности при
заданной кристаллографической ориентации, с полным отсутствием нарушенного
слоя, минимальной плотностью поверхностных дефектов, дислокаций и т.д., [4].
1. ФИЗИКО-ХИМИЧЕСКИЕ СВОЙСТВА МАТЕРИАЛА
Кремний, как и другие элементы, обладает рядом физико-химических свойств,
которые позволяют определенным образом обрабатывать его, для получения
полупроводниковых подложек.
Основные свойства кремния приведены в таблице 1,[5].
Таблица 1.1 Основные химические свойства кремния
|
Атомный номер
|
14
|
|
Атомная масса
|
28,086
|
|
Плотность, кг/м³
|
2330
|
|
Температура плавления, °С
|
1410
|
|
Температура кипения, °С
|
2600
|
|
Теплоемкость, кДж/(кг·°С)
|
0,678
|
|
Ширина запрещенной зоны
|
1,205-2,84·10−4·T
|
К физико-химическим свойства кремния относятся так же свойства кремния
реагировать с различными веществами: кислотами, щелочами, кислородом.
При реакции с кислородом кремний образует естественный оксид SiO2, что является одним из важнейших химических свойств
кремния.
· Травители, для которых контролирующей стадией является
диффузия, называются полирующими. Типичными полирующими травителями для
кремниевых пластин являются смеси азотной и фтористоводородной (плавиковой)
кислот.
· Травители, для которых контролирующей стадией является
химическая реакция, называются селективными. В качестве селективных травителей
пластин кремния используют водные растворы щелочей (например, NaOH, КОН) и
гидразин гидрат ' .
.
· Для щелочных травителей изменение скорости травления
соответствует схеме (100) >(110)> (111).
· Травление с большой разницей скоростей травления в различных
кристаллографических направлениях называют анизотропным,[6].
Щелочные реагенты являются в основном анизотропными травителями с
преимущественным воздействием на кристаллографические плоскости с малыми
индексами. На рис. 1 показан пример преимущественного травления 54о-
ой канавки в пересечении 110/100/111 смесью гидроксид калия и изопропанола при
85оС. Гидроксид калия и изопропанол являются травителями с
соотношением скоростей травления 55:1 для направлений <100> и
<111>, [7]

Рисунок 1 - Анизотропное (а) и изотропное (б) жидкостное
травление
эпитаксиального кремния.
Таблица 1.2 Изотропное и анизотропное травление кремния[8]
|
Травитель
|
Скорость травления, мкм/мин
|
Подтравливание (мкм/сторону)1)
|
|
PS
|
ES
|
BS
|
PS
|
ES
|
BS
|
|
Изотропный2) Изотропный3) Анизотропный4)
|
3 0.8 0.7
|
4 0.6 0.9
|
4 0.5 1.1
|
1.5d 1.0d (0.1-1.0)d
|
1.5d 1.0d <0.1d
|
1.5d 1.0d <0.1d
|
) d- глубина травления. 2) HNO3 (65%)/HF(40%)/NaNO2=95/5 мл/г.
) HNO3(65%)/H2O/HF(40%)=100/40/6мл. 4) KOH/H2O/n-пропанол=15г/50/15
мл.
Таблица 1.3 Изотропные травители для кремния[8]
|
Травитель
|
Применение
|
|
HF, HNO3, CH3COOH
HF, HNO3, CH3COOH HF, KMnO4, CH3COOH
HF, HNO3, H2O2+NH4OH HF, HNO3,
CH3COOH HF, HNO3 NH4F, H2O2
HF, HNO3, I2 HF, HNO3, CH3COOH
HNO3, HBF4, NH4BF4 NH4F,
H2O2, NH4HPO4 KOH+спирт
|
Все разновидности Si Низкоомный Si Эпитаксиальный Si
Удаление примесей Cu pnp - многослойные структуры pnp - многослойные
структуры Минимальное подтравливание Общее травление Подтравливание плоскости
(100) Маска из резиста AZ-1350 Скорости травления, Si/ФСС=2/1
Поликристаллический Si
|
Таблица 1.4 Анизотропные травители для кремния[8]
|
Травитель
|
Применение
|
|
Этиледиамин, пирокатехин, H7O Этиледиамин,
пирокатехин Гидразин, ИПС, H2O КОН, sec-спирты КОН,
этиленгликоль Диамины, КОН, ИПС КОН, ИПС, H2O R3N+OH,
ИПС, H2O R3N+OH, поверхностно-активное ве-щество R3N+OH H3PO4+следы As2O3 CuF2, маска из резиста
AZ-1350
|
100 SiO2, Si3N4, выявление
точечных проколов 100, Al-маска 100 Текструрирование элементов солнечных
батарей Не разрушается Al 100 100 H2 Устранение Na+ из
травителя n-тип Электролитическое травление
|
2. ЭЛЕКТРОФИЗИЧЕСКИЕ СВОЙСТВА МАТЕРИАЛА
.1 Кристаллографическая ориентация
Характерные прямые линии, выходящие из точки отсчета, вдоль которых в
кристаллической решетке располагаются атомы, называют кристаллографической
ориентацией. Точками отсчета могут служить вершины куба, а кристаллографическими
направлениями - его ребра и диагонали, а также диагонали граней (рис. 2, а).
Для определения индекса какого-либо направления необходимо найти индекс
ближайшего к данной точке отсчета атома, находящегося на данном направлении.
Например, индекс ближайшего атома вдоль оси ОХ обозначается цифрами 100 (рис.
2,а). Эти цифры представляют собой координаты упомянутого атома относительно
точки О, выраженные через количество параметров вдоль осей OX, OY и OZ
соответственно. Индексы направления ОХ и параллельных ему направлений
обозначаются [100]. Соответственно направления OY и OZ обозначаются [010] и
[001]. Кристаллографические направления вдоль диагоналей граней XOZ, XOY и YOZ
обозначают [101], [110] и [011]. Пользуясь указанной методикой, можно
определить индекс любого направления. Например, индекс направления вдоль
диагонали куба выразится так: [111]. Для определения индекса
кристаллографической плоскости необходимо вначале найти координаты ближайших
точек ее пересечения с осями координат, проведенными из точки отсчета О. Затем
взять обратные им величины и записать их в круглых скобках в обычной
последовательности. Например, координатами точек пересечения с осями координат
ближайшей плоскости, параллельной плоскости XOY, выраженными через параметры
решеток, являются числа Ґ, Ґ, 1 (см. рис. 2, б). Поэтому индекс этой плоскости
можно записать в виде (001). Индексами плоскостей, параллельных плоскостям XOZ
и YOZ, окажутся выражения (010) и (100) (рис. 2, б). Индекс вертикальной
диагональной плоскости куба выразится через (110), (рис. 2, в), а индекс
наклонной плоскости, пересекающейся со всеми тремя осями координат на удалении
одного параметра, примет вид (111) (см. рис. 2, г).[9]

а б в г
Рисунок 2.1 - Виды кристаллографической ориентации
Методы определения кристаллографической ориентации:
Разрушающие методы - селективное травление.
Неразрушающие методы, [10]:
· Метод Лауэ.
· Метод вращения монокристалла
· Метод порошка (Дебая)
Суть метода селективного травления заключается в следующем:
Когда травление производится продолжительное время, на гранях кристалла
образуются правильные фигуры, которые получили название фигур травления. Они
легко наблюдаются под микроскопом. Установлено, что фигуры травления на
различных кристаллографических плоскостях различны. По геометрии фигур
травления можно судить об ориентации кристалла, а также о его
монокристалличности. Если образец не представляет собой монокристалла, в
различных местах одной и той же грани фигуры травления будут различными.
Точность определения ориентации кристалла методом фигур травления составляет
2-3°, [28].
Метод Лауэ - метод исследования структуры кристаллов с помощью
рентгеновских лучей, один из методов рентгеновского структурного анализа.
Представляет собой усовершенствованную методику опыта, поставленного в 1912 г.
В. Фридрихом и П. Книппингом по предложению М. Лауэ, в этом эксперименте была
открыта дифракция рентгеновского излучения на кристалле. В методе Лауэ тонкий
пучок рентгеновских лучей непрерывного спектра падает на неподвижный
монокристалл, закреплённый на гониометрической головке. Излучение, рассеянное
кристаллом в направлениях, определяемых условием Брэгга - Вульфа, регистрируется
на плоской фотоплёнке, помещённой за кристаллом перпендикулярно падающему пучку
лучей; полученное изображение называется лауэграммой. В случае крупных
монокристаллов фотоплёнка располагается перед кристаллом, а лауэграмма,
полученная таким способом, называется эпиграммой.

Рисунок 2.2 - Суть метода Лауэ
Метод Лауэ применяется для пространственной ориентировки
монокристаллов (в особенности неогранённых), определения точечной группы
симметрии кристаллов, исследования реальной структуры и совершенства
внутреннего строения монокристаллов. Метод Лауэ используется также для
исследования процессов старения и распада в метастабильных фазах, перестройки
кристаллической структуры под действием температуры, облучения нейтронами или γ
- излучением, а также
неупругих когерентных процессов рассеяния рентгеновского излучения и др.
проблем.
В данной работе кристаллографическая ориентация
определена методом селективного травления.
.2 Удельное сопротивление
Удельное электрическое сопротивление, или просто
удельное сопротивление вещества - физическая величина, характеризующая
способность вещества препятствовать прохождению электрического тока.
Методы определения удельного сопротивления:
· Метод вихревых токов
· Четырехзондовый метод
Суть четырехзондового метода показана на рисунке 2.3.
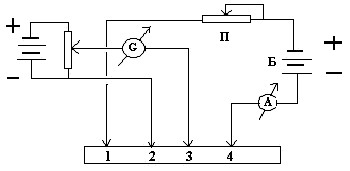
Рисунок 2.3 - Схема измерения поверхностного и удельного сопротивлений
четырехзондовым методом: 1-4 - зонды; 5 - источник тока; 6 - пластина
С помощью источника тока по амперметру А в цепи токовых зондов 1-4
устанавливается ток. Вольтметром V с большим входным сопротивлением
измеряют напряжение между зондами 2 и 3 при двух противоположных направлениях
тока, получают значения U23 и U32. Далее, в расчетах используют
среднее значение напряжения. Вычислив среднее значение напряжения между зондами
2 и 3, находят поверхностное сопротивление (кОм/ ). Удельное сопротивление (Ом·см)
вычисляют по формуле:
). Удельное сопротивление (Ом·см)
вычисляют по формуле:
 ,
,
Где S -
толщина подложки, а  :
:
 ,
,
Все расчеты производятся для подложки германия,
толщиной 3мм. Начальные данные эталона: Rэт=1000 Ом, Uэт=0,44 В, Iэт=440мкА. При помощи четырехзондового метода определяем Uх=0,0025 В. По закону Ома определяем Rх:
Rх=25*10-4/44*10-5,
Rх=5,7 Ом.
Определим добавочный коэффициент k:

Размеры подложки указаны на рисунке 2.4.

Рисунок 2.4 - Размеры экспериментальной подложки
кремния в мм.
Как видно из рисунка 2.4 - а = 13 мм, b=22 мм.
 ;
;  ,
,
по таблице [12], k1 горизонтальное значение, k2 - вертикальное. На пересечение находим значение k=2,35.
Отсюда:
 Ом*
Ом* ,
,
Значит удельное сопротивление  :
:
 ,
,
2.3 Тип проводимости
Тип проводимости - это характеристика
полупроводниковой подложки, основанная на соотношении концентрации электронов и
дырок. Если основными носителями заряда являются электроны, такая проводимость
называется электронной, а полупроводник с электронной проводимостью -
полупроводником N-типа. Если основными носителями заряда являются дырки, такая
проводимость называется дырочной, а полупроводник с дырочной проводимостью -
полупроводником Р-типа.
Методы определения типа проводимости:
· Метод термоЭДС
· Фотоэлектрохимический метод
· Метод Холла
Для экспериментальной подложки кремния приведенной в этой работе, тип
проводимости определяется методом термоЭДС. По нему получено, что подложка p-проводимости. Суть метода приведена
ниже.

Рисунок 2.5 - Установка:1 - термозонд; 2 - холодный зонд; 3 - исследуемый
образец; 4 - резистивный нагреватель; 5 - источник питания нагревателя; 6 -
нуль-гальванометр.
Рисунок установки для определения типа проводимости образцов,[7]. Если в
полупроводнике создать градиент температуры, в нем будет наблюдаться градиент
концентраций носителей заряда. В результате возникнет диффузионный поток
носителей заряда и связанный с ним диффузионный ток. В образце возникнет
разность потенциалов, которую принято называть термоЭДС. Знак термоЭДС зависит
от типа проводимости полупроводника. Так как в полупроводниках два типа
носителей заряда, диффузионный ток складывается из двух составляющих, а знак
термоЭДС зависит от преобладающего типа носителей заряда. Установив знак
термоЭДС с помощью гальванометра, можно сделать вывод о типе проводимости
данного образца.
2.4 Концентрация основных носителей заряда
Концентрация основных носителей заряда - количество
носителей заряд (электронов или дырок), на кубический объем подложки - см3.
Методы определения концентрации:
· Метод вольт-фарадных характеристик барьера Шоттки.
· Метод плазменного резонанса.
· Определение концентрации по эффекту Фарадея.
В данной работе будем пользоваться формулой, позволяющей рассчитать
концентрацию, при известном удельном сопротивлении:
 ;
; ;
;
где q=1,6*10-19. µn = 3800, для германия. Отсюда:
 ;
;
Откуда
 ,см3
,см3
2.5 Подвижность носителей заряда
Подвижность носителей заряда в электронных проводниках
- отношение скорости направленного движения носителей заряда - электронов
проводимости и дырок (дрейфовой скорости vдр), вызванного
электрическим полем, к напряжённости Е этого поля:
 [8].
[8].
Методы определения подвижности носителей заряда.
· Метод геометрического магнитосопротивления
· Метод СВЧ генерации
· По эфекту Холла
· Метод Ван-дер-Пау
Для кремния в данной работе берутся стандартные значения μp=500 см2/В*с, μn=1300 см2/В*с, [16].
2.6 Диффузионная длина неосновных носителей заряда
Диффузионная длина в полупроводнике - расстояние, на
котором плоский диффузионный поток неравновесных носителей заряда (в отсутствие
электрического поля) уменьшается в е раз. Диффузионная длина L
имеет смысл среднего расстояния, на которое смещаются носители заряда в
полупроводнике вследствие диффузии за время τ их жизни:
 ,
,
где D - коэф. диффузии носителей заряда
в полупроводниках.[7]
Определение диффузионной длины методом подвижного светотока, показано на
рисунке 2.6.
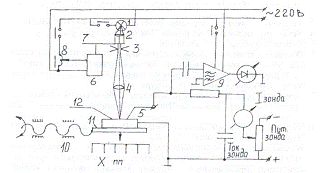
Рисунок 2.6 - Схема устройства для определения диффузионной длины
носителей: 1 - лампа; 2 - конденсор; 3 - щель; 4 - объектив; 5 - зонд; 6 -
электродвигатель; 7 - диск-прерыватель; 8 - трансформатор регулирования
оборотов; 9 - узкополосный усилитель; 10 - микрометрический винт с отсчетным
устройством; 11 - столик; 12 - исследуемый полупроводниковый кристалл
На поверхность кристалла падает полоска света шириной около 0,2 мм. Для
сбора носителей используют зонд - заостренную вольфрамовую проволоку, точечно
контактирующую с кристаллом. Когда на зонд подают напряжение (несколько вольт),
он становится коллектором носителей, имеющих знак заряда, противоположный знаку
потенциала. При вычислении диффузионной длины следует помнить о знаке заряда
носителей, поведение которых изучается. В нашем случае на зонд подают
отрицательное смещение, чтобы собрать дырки. Зонд собирает любые носители
данного знака, как неравновесные, так и равновесные. Чтобы регистрировать
только неравновесные носители, применяют прерывистое освещение образца с
последующим узкополосным усилением сигнала. Из-за прерывания светового пучка
неравновесные носители то возникают, то исчезают. Поэтому ток зонда и падение
напряжения на сопротивлении R помимо постоянной составляющей,
обусловленной равновесными неосновными носителями, содержат прерывистую
составляющую, связанную с неравновесными носителям. Только эта составляющая
усиливается узкополосным усилителем, настроенным на частоту прерывания света,
детектируется и подается на вольтметр, [28].
Снятые значения приведены в таблице 2.1.
Таблица 2.1 Значения U
снятые с установки
|
№
|
Шаг Х, мм
|
Uc, мкВ
|
U0, мкВ
|
Uх
|
|
1
|
0
|
80
|
30
|
50
|
|
2
|
0,11
|
72
|
|
42
|
|
3
|
0,22
|
70
|
|
40
|
|
4
|
0,33
|
64
|
|
34
|
|
5
|
0,44
|
58
|
|
28
|
|
6
|
0,55
|
56
|
|
26
|
|
7
|
0,66
|
53
|
|
23
|
|
8
|
0,77
|
51
|
|
21
|
|
9
|
0,88
|
49
|
|
19
|
|
10
|
0,99
|
46
|
|
16
|
|
11
|
1,01
|
43
|
|
13
|
Рассчитаем значения диффузионной длины Lp для всех соседних
значений х,
по формуле:
Lp= (x2 - x1) / (ln (Ux1) - ln (Ux2)
И занесем их в таблицу 2.2.
Таблица 2.2 Рассчитанные значения Lp
|
№
|
Шаг Х, мм
|
Lp,мм
|
|
1
|
0
|
0.631
|
|
2
|
0,11
|
2.255
|
|
3
|
0,22
|
0.677
|
|
4
|
0,33
|
0.567
|
|
5
|
0,44
|
1.484
|
|
6
|
0,55
|
0.897
|
|
7
|
0,66
|
1.203
|
|
8
|
0,77
|
1.099
|
|
9
|
0,88
|
0.640
|
|
10
|
0,99
|
0.530
|
|
11
|
1,01
|
-
|
Среднее значение Lp (исключая максимальное и минимальное значения):
Lp=0.900522, мм
.7 Время жизни неосновных носителей зарядов
Время жизни τ - промежуток времени, за который концентрация
неравновесных носителей уменьшается в е раз вследствие рекомбинации.
Методы измерения времени жизни.
· Измерения методом Хайнса-Шокли при наличии электрического
поля
· Затухание фотопроводимости
· Поверхностная фото-ЭДС
· Фотоэлектромагнитный эффект
· Иные способы
Альтернативные способы измерения - известен способ измерения времени
жизни носителей заряда методом использования двух лучей инфракрасного
диапазона, применяемый для определения времени жизни носителей заряда в
образцах кремния в форме брусков прямоугольного сечения миллиметровых размеров
в сечении. Метод включает в себя: а) резку, шлифовку, полировку и химическую
обработку граней образца, б) освещение одной грани образца импульсным лучом
лазера с длиной волны 1,06 мкм и длительностью импульса менее измеряемого
времени жизни с целью импульсной инжекции избыточных носителей в измеряемую
область пластины за счет генерации электронов и дырок, в) освещение другой
грани, примыкающей к вышеназванной, непрерывным лучом лазера с длиной волны
3,39 мкм, с диаметром луча меньшим, чем ширина освещаемой им грани, с целью
тестирования количества введенных носителей заряда по поглощению на свободных
носителях, г) регистрацию временной зависимости интенсивности излучения 3,39
мкм, прошедшего через образец, с использованием фотоприемника с инерционностью
меньшей, чем измеряемое время жизни, д) варьирование координаты точки падения
тестирующего луча 3,39 мкм на грань и е) математическую обработку измеренной
временной и координатной зависимостей сигнала фотоприемника. В результате
математической обработки, представляющей собой сопоставление измеренных
зависимостей с результатами расчетов по физической модели поведения
инжектированных носителей во времени и в пространстве, учитывающей процесс
рекомбинации носителей на поверхности, определяются объемное время жизни и
скорость поверхностной рекомбинации, [15].
В данной работе расчёт данной величины будет вестись по среднему значению
диффузионной длины Lp,
найденному выше, используя соотношение
 .
.
Значение Др для кремния определяют по формуле Др =
μp · k ·T/q, где μр -подвижность дырок; Т - температура (Т =
300 К); q - заряд электрона. [28]
Др=12,5 см2/с.
Из значения диффузионной длины, вычисляем время жизни зарядов, по
формуле:
 ,
,
 ,
,
 , с
, с
.8 Сравнение рассчитанных величин со справочными
Все значения обобщенно сведем в таблице. Справочное значение взято из
[16].
Таблица 2.3 - Сравнение значений электрофизических параметров кремния со
справочными
|
№
|
Параметр
|
Измеренное значение
|
Справочное значение
|
|
1
|
Удельное сопротивление  , ,
|

|
0,1-50
|
|
2
|
Концентрация основных носителей заряда, см3
|

|
5,81·1015
|
|
3
|
Подвижность носителей заряда, см2/В*с
|
---
|
μp=500, μn=1300
|
|
4
|
Диффузионная длина неосновных носителей зарядов, мм
|
0,900522
|
0,330054
|
|
5
|
Время жизни неосновных носителей зарядов, с
|
0,000649
|
5*10-9/10*10-6
|
3. ТЕХНОЛОГИЧЕСКИЙ АЛГОРИТМ ПРОИЗВОДСТВА ПОДЛОЖКИ
.1 Технологический алгоритм
. Выращенный методом Чохральского кристалл диаметром 100 мм
получен с завода-изготовителя
. Калибровка кристалла
. Проверка на кристаллографическую ориентацию
. Резка на подложки
. Контроль нарезанных подложек
. Первое шлифование
. Отмывка
. Второе шлифование
. Отмывка
. Окончательное шлифование
. Отмывка
. Контроль шлифованных подложек
. Первое полирование
. Второе полирование
. Окончательное полирование
. Отмывка
. Контроль полированных подложек
. Химико-механическое полирование
. Выходной контроль подложки
3.2 Обоснование технологического алгоритма
.2.1 Калибровка кристалла
Калибровка монокристаллов полупроводниковых
материалов. Монокристалл после охлаждения калибруют по диаметру до заданного
размера (до 300 мм) с точностью +/- 1 мм. Калибровка обеспечивает придание им
строго цилиндрической формы и заданного диаметра. Калибровку монокристаллов
полупроводников проводят чаще всего методом круглого шлифования на
универсальных круглошлифовальных станках, снабженных алмазным шлифовальным
кругом с зернистостью, обозначенной 50/40 (основная фракция 40 мкм, а
количество крупной, размером 50 мкм, не более 15%). Перед операцией калибровки
к торцам монокристалла наклеечной мастикой приклеивают металлические конуса
(«центры») таким образом, чтобы их ось совпадала с продольной осью
монокристалла.
После калибровки на поверхности монокристалла
образуется нарушенный слой глубиной 50...250 мкм в зависимости от скорости
продольной подачи. Присутствие его на периферии подложек может вызывать
появление сколов, а при последующей высокотемпературной обработке приводить к
генерации структурных дефектов, распространяющихся в центральные области
подложки. Для снятия нарушенного слоя прошедшие операции калибровки
монокристаллы полупроводников подвергают операции химического травления, [18].
.2.2 Проверка на кристаллографическую ориентацию
Правильная ориентация пластин обеспечивает высокую воспроизводимость
электрофизических параметров создаваемых на пластине микросхем. Перед нарезкой
кристалла на пластины проверяют выращенный кристалл на его кристаллографическую
ориентацию. Применяют метод Лауэ - он приведен выше, в разделе
«Электрофизические свойства». После проверки, кристалл разрезается по нужной
ориентации на пластины, которые будут в дальнейшем обрабатываться.
Для обозначения кристаллических направлений
монокристаллические подложки обычно имеют срезы вдоль окружности. Наиболее
распространенным является стандарт SEMI.
Если меньший срез повернут на 180° от большего среза,
значит это подложка n-типа с ориентацией <100> .
Если меньший срез сделан на 90° слева или справа, то
подложка p-типа с ориентацией <100> .
Если меньший срез сделан на 45° слева или справа, то
это n-типа, <111>.
Если срезов нет совсем, то это p-тип, <111>.
После химического и рентгеноскопического анализа для проверки степени его
чистоты и молекулярной ориентации он загружается в установку для резки кремния
на пластины (подложки), [19].
.2.3 Резка пластин
Процесс включает в себя разрезание монокристаллического слитка на тонкие
(от 0,9 до 1,1 мм) плоскопараллельные пластины.
Методы резки кристалла на пластины, [17].
· Метод резки проволокой с применением абразива
· Метод резки алмазным диском с внешней режущей кромкой
· Метод резки алмазным диском с внутренней режущей кромкой
Рассмотрим последний приведенный метод. На шпиндель станка крепят
алмазный диск и с помощью специальных растягивающих болтов регулируют его
радиальное натяжение. Внутрь полого шпинделя помещают держатель с приклеенным к
нему полупроводниковым слитком. Перед началом весь слиток находится внутри
шпинделя, а торцовая его часть немного выступает за кромку плоскости алмазного
диска. При включении станка шпиндель с закрепленным на нем алмазным диском
начинает вращаться. Если держатель со слитком перемещать в горизонтальном (или
вертикальном) направлении, то в определенный момент слиток коснется своей
боковой поверхностью кромки алмазного диска и начинается процесс резки. При
полном отрезании пластины от слитка держатель отводится в исходное
первоначальное положение и выдвигается из шпинделя на длину, равную толщине отрезаемой
пластины. После этого процесс повторяется. Каждое алмазное зерно, закрепленное
на кромке металлического диска, представляет собой микрорезец, который
скалывает микрочастицы с обрабатываемой поверхности полупроводникового
материала. Процесс резания идет при большой частоте вращения шпинделя (3000 -
5000 об/мин). При резке происходит выделение большого количества теплоты в
месте соприкосновения алмазной кромки диска с поверхностью полупроводникового
материала, поэтому в течение всего процесса резки в область контакта
диск-слиток непрерывно подают охлаждающую жидкость. Схема устройства приведена
на рисунке 3.2.3
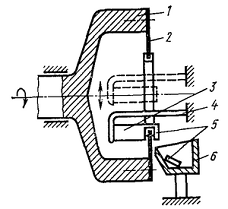
Рисунок 3.2.3 Устройство для резки монокристаллов кремния. 1 - шпиндель, 2 -
диск с алмазной кромкой, 3 - слиток, 4 - держатель слитка, 5 - отрезанная
пластина, 6 - сборник.
Наш монокристалл будет разрезан при помощи способа резки алмазным диском
с внутренней режущей кромкой. Такой метод выбран за его простоту, удобство,
высокую производительность. Резка алмазным кругом с внутренней режущей кромкой:
зернистость режущей кромки АСМ 60/53;n=4000мин-1; подача 1мм/мин. Толщина
нарезанной пластины будет примерно 550 мкм, с допуском на обработку - шлифовку
и полировку.
.2.4 Шлифование
Под процессом шлифования понимают обработку полупроводниковых пластин на
плоскошлифовальных прецизионных станках с использованием абразивных материалов
с размером зерна около 40 мкм (микропорошки). Чаще всего применяют группы
микропорошков с зернами 14 мкм и меньше. Микропорошки М14, М10, М7, М5
изготавливаются из карбидов бора, кремния и электрокорунда, микропорошки марок
АСМ - из алмаза.
По технологическим признакам шлифование подразделяют на предварительное
(с более крупным порошком) и окончательное (с более мелким порошком), по конструктивным
признакам - на одностороннюю и двустороннюю, по виду используемого материала -
на шлифование свободным и связанным абразивом. Цель предварительного шлифования
- быстро выровнять плоскости пластин и удалить припуск. Режимы проведения этого
процесса отличаются более высокими частотой вращения шлифовальников и
давлениями абразивного микропорошка на поверхность пластины. Окончательное
шлифование характеризуется более мягкими режимами обработки. Целью
окончательного шлифования является дальнейшее улучшение геометрических
параметров и качества поверхности обрабатываемых пластин. При шлифовании
полупроводниковые пластины располагают так, чтобы они соприкасались с
поверхностью шлифовальника. При вращении шлифовальника поверхность
шлифовальника и пластин плотно прилегают друг к другу. В зону шлифования подают
абразивную суспензию, что создает определенное давление, которое приводит к
выкалыванию микрочастиц полупроводникового материала. Шлифование свободным
абразивом выполняют с использованием различных суспензий и паст. В процессе
обработки зерна абразива находятся в свободном состоянии, т.е. не связаны
жестко друг с другом. Абразивная суспензия создает тонкую прослойку между
шлифовальником и обрабатываемой пластиной, в которой абразивные зерна свободно
перетекают. Шлифование связанным абразивом выполняют на станках с жесткими
осями, особенностью которых является неизменность положения осей вращения
шлифовальника и обрабатываемых пластин. [20]
Пластина будет обрабатываться трижды, с обеих сторон:
· Предварительное шлифование проводим свободным абразивом,
например суспензией порошка ЭБМ-10, до глубины нарушенного слоя 11-15 мкм.
· Повторное шлифование проводим суспензией порошка ЭБМ-5, до
глубины нарушенного слоя 9-12 мкм.
· Окончательная шлифовка проводится связанным абразивом на
круге шлифовальника, пастой АСМ-28, до глубины нарушенного слоя 7-9 мкм. [21]
.2.5 Полирование
Для улучшения качества обработки поверхности полупроводниковых пластин и
уменьшения глубины механически нарушенного слоя проводят процесс полировки.
Процесс полирования отличается от процесса шлифования технологическим режимом,
размером зерна и видом абразива, а также материалом полировальника. Обработка
происходит с использованием свободного абразива. Процесс полирования проводят на
мягких полировальниках, которые представляют собой жесткие диски, обтянутые
мягким материалом. В качестве абразива используют микропорошки синтетического
алмаза, оксида алюминия, оксида хрома, диоксида кремния. Полировочный материал
должен удерживать частицы абразивного материала в процессе обработки пластин.
Процесс полирования пластин может происходить в несколько этапов. Для начала
применяют микропорошки с более крупной зернистостью. На последующих этапах,
после проведения операции очищения от следов предыдущей обработки, меняют
материал полировальника и используют более мелкие микропорошки. Нагрузка на
полупроводниковые пластины несколько увеличивается. Водная суспензия в течение
всего процесса полирования тщательно перемешивается. Последний этап полирования
имеет большое значение. Он дает возможность удалить фон частиц с поверхности
пластин, возникающий на первых этапах полировки и значительно уменьшить глубину
механически нарушенного слоя. Так же могут применяться химико-механические
способы полирования, которые отличаются высокой химической активностью по
отношению к обрабатываемому полупроводниковому материалу, [19].
Полирование пластины проводим в несколько этапов, с рабочей стороны:
· Предварительное полирование алмазной пастой АСМ-3 на мягкой
ткани до глубины нарушенного слоя 6-9 мкм.
· Повторное полирование алмазной пастой АСМ-1 на мягкой ткани
до глубины нарушенного слоя 4-6 мкм.
· Окончательное полирование алмазной пастой АСМ-0,5 на мягкой
ткани до глубины нарушенного слоя 3-1 мкм., [28].
.2.6 Химико-механическое полирование
К физически адсорбированным загрязнениям относятся все виды механических
частиц (пыль, волокна, абразив, металлические включения), а также все виды
органических материалов, связанные с поверхностью подложки силами физической
адсорбции. Удаление органических загрязнений требует более сложного процесса
отмывки, так как при нагревании они разлагаются и выделяют газообразные
вещества, ухудшающие последующие технологические процессы.
К химически адсорбированным загрязнениям относятся различные виды
оксидных и сульфидных пленок на поверхности пластин, катионы и анионы
химических веществ. Таким образом, для полной очистки подложки от загрязнений
используют ряд последовательных операций, каждая из которых удаляет несколько
видов загрязнений. Травление является обязательной технологической операцией,
[19].
При травлении кремния роль окислителя выполняет азотная кислота.
Фтористоводородная (плавиковая) кислота, входящая в состав травителя,
переводит окись кремния в тетрафторид кремния. Для травления, дающего
зеркальную поверхность пластин, используют смесь указанных кислот в соотношении
3:1, температура травления 30...40°С, время травления около 15 с.
Химико-механическое полирование проводим в два этапа:
· Первичное полирование суспензией аэросила, SiO2(зерно
0,04 - 0,3 мкм), до глубины нарушенного слоя 2-1 мкм.
· Окончательное полирование суспензией цеолита, до глубины
нарушенного слоя 1-0,5 мкм., [28].
.2.7 Отмывка полупроводниковых пластин
На всем протяжении процесса создания необходимых слоев на поверхности
подложки последняя регулярно проходит очистку от продуктов завершённых
последовательных технологических операций, чтобы можно было приступить к
следующим.
Отмывка состоит из двух этапов: 1)обезжиривание подложек в органических
растворителях, 2) промывка в особо чистой воде. Обезжиривание подложек проводят
для удаления органических физических загрязнений. Для отмывки подложек часто
используют различные смеси растворителей, которые позволяют проводить отмывку
полярных и неполярных органических загрязнений. Например, фреон-хлористый
метилен, фреон-изопропиловый спирт, фреон-ацетон и др. Процесс обезжиривания в
органических растворителях в сильной степени зависит от режима его проведения
(температуры, длительности и скорости смены отработанного растворителя).
Часто для интенсификации процесса и улучшения качества применяют
ультразвуковые ванны. Полупроводниковые пластины загружают в кассеты, которые
последовательно опускают в несколько ванн с растворителем или смесью растворителей.
Происходит удаление наиболее грубых жировых загрязнений, снимаются оставшиеся
при первой обработке участки жировых покрытий и окончательная отмывка подложек.
Весьма эффективным методом является обработка пластин в парах кипящих
растворителей - пары растворителя более эффективно взаимодействуют с
загрязнениями и растворяют их. В процессе обезжиривания происходит
взаимодействие растворителя с различными видами загрязнений и в результате
десорбции молекулы этих загрязнений переходят с поверхности полупроводниковой
подложки в приповерхностный слой растворителя, а молекулы растворителя оседают
на поверхности подложки. Происходит замещение адсорбированных молекул
загрязнений молекулами растворителя. Таким образом, в процессе обезжиривания на
поверхности подложки создаются слои растворителя, которые необходимо удалить.
Остатки растворителя и частиц продуктов удаляют промывкой в особо чистой воде.
Деионизованная вода, характеризуется удельным сопротивлением 1-20 МОм*см. Для
идеально чистой воды ρ=25 мОм, [20].
3.2.8 Контрольные операции
Требования к подложкам, выполненным из кремния, приведены в таблицах
3.2.8.1-3.2.8.3, [28].
Таблица 3.2.8.1 - Размеры подложек кремния
|
Диаметр, мм
|
60
|
76
|
100
|
150
|
200
|
|
Номинальная толщина, мкм
|
350
|
380
|
460
|
625
|
900
|
|
|
420
|
500
|
|
|
|
|
450
|
525
|
|
|
|
|
500
|
580
|
|
|
|
|
|
600
|
|
|
Таблица 3.2.8.2 - Параметры подложек, выполненных из кремния
|
Параметры пластин
|
Допустимое значение параметров
|
|
Диаметр, мм
|
60
|
76
|
100
|
125
|
150
|
|
Допуск на диаметр, мм
|
±0,5
|
|
Толщина, мкм
|
350
|
380
|
525
|
625
|
675
|
|
Допуск на толщину, мкм
|
±25
|
|
Длина базового среза, мм
|
18
|
22
|
32,5
|
42,5
|
50
|
|
Допуск на длину базового среза, мм
|
±3
|
±2,5
|
±3
|
|
Длина допуска среза, мм
|
10
|
11
|
20
|
18
|
17,5
|
|
Неплоскостность, мкм
|
7
|
5
|
|
Непараллельность сторон, мкм Прогиб, мкм
|
8
|
10
|
13
|
15
|
18
|
|
Количество рисок, шт.
|
3
|
|
Суммарная длина рисок, мм
|
15
|
19
|
25
|
31
|
38
|
|
Количествово частиц загрязнения на пластине, шт.
|
10
|
|
Отклонение от ориентации, град.
|
±1
|
|
Шероховатость рабочей поверхности
|
Rz < 0,05 мкм
|
|
Шероховатость нерабочей поверхности
|
Ra < 0,1 мкм
|
|
Дефектность поверхностного слоя
|
Полное отсутствие нарушенного слоя и механических упругих
напряжений. Плотность дислокаций не выше объемной.
|
|
Адсорбированные примеси:
|
|
атомы (атом/см2) ионы (ион/см2)
молекулы (монослой)
|
Меньше 1012-14 Меньше 1012-14 Меньше
одного монослоя
|
|
|
|
|
|
|
|
|
|
|
|
|
Таблица 3.2.8.3 - Классы шероховатости поверхности
|
Класс
|
Параметр шероховатости, мкм
|
l
|
|
Ra
|
Rz
|
|
|
8
|
а
|
От 0,63 до 0,5 вкл.
|
-
|
0,8
|
|
б
|
0,5-0,4
|
-
|
|
|
в
|
0,4-0,32
|
-
|
|
|
9
|
а
|
От 0,32 до 0,25 вкл.
|
-
|
0,25
|
|
б
|
0,25-0,2
|
-
|
|
|
в
|
0,2-0,16
|
-
|
|
|
10
|
а
|
От 0,16-0,125 вкл.
|
-
|
0,25
|
|
б
|
0,125-0,1
|
-
|
|
|
в
|
0,1-0,08
|
-
|
|
|
11
|
а
|
От 0,08-0,063 вкл.
|
-
|
0,25
|
|
б
|
0,063-0,05
|
-
|
|
|
в
|
0,05-0,04
|
-
|
|
|
12
|
а
|
От 0,04-0,032 вкл.
|
-
|
0,25
|
|
б
|
0,032-0,025
|
-
|
|
|
в
|
0,025-0,02
|
-
|
|
|
13
|
а
|
-
|
От 0,1-0,08 вкл.
|
0,08
|
|
б
|
-
|
0,08-0,063
|
|
|
в
|
-
|
0,063-0,05
|
|
|
14
|
а
|
-
|
От 0,05-0,04 вкл.
|
0,08
|
|
б
|
-
|
0,04-0,032
|
|
|
в
|
-
|
0,032-0,025
|
|
Контроль качества полупроводниковой пластины проводят различными
методами, [21]:
· Микроскопия: оптическая, ИК, атомно-силовая, туннельная,
растровая электронная
· Диагностика поверхности и приповерхностного слоя с
использованием оптического, ИК, рентгеновского, лазерного излучения
(рассеивания)
· Емкостные кондуктометрические методы
· Профилометрия
· Сканирующая акустическая топография
· Эллипсометрия
· Интерферометрия
Измерения выполняются в чистой комнате класса 1 (10). Допустимое значение
неплоскостности 0.1 (0.5) мкм. Не допускаются свирли и микровключения,
царапины. Для такого высокоточного и широко применяемого контроля необходима
аппаратура, на которой возможно проводить контрольные операции всех этапов без
потерь времени и материала. В приведенном выше технологическом алгоритме
множество различных контрольных операций: контроль нарезанный, шлифованных,
полированных пластин, выходной контроль готовой продукции. Дабы не загромождать
технологический цех множеством приборов, предлагается использовать систему
инспекции поверхности чистых пластин KLA-Tencor SurfScan SP1TBI. Она
предназначена для решения задач инспекции поверхности полупроводниковых пластин
на стадии подготовки к нанесению топологии на поверхность. Добавление к
классической конфигурации оптической системы измерительного комплекса SP1
освещения поверхности с помощью косого луча позволяет производить определение
крайне малых дефектов на поверхностях с высокой шероховатостью для разработки и
производства изделий по технологии 0.18/0.13 мкм. Кроме того, KLA-Tencor
SurfScan SP1TBI так же позволяет проводить обнаружение всех возможных вариантов
ям, каверн и т.п. Определение таких дефектов является критичным для
производства полупроводниковых изделий и их отбраковки непосредственно в
процессе производства на конвейере. Осесимметричный дизайн системы SurfScan
SP1TBI позволяет использовать адаптивную оптику для увеличения соотношения
сигнал-шум при проведении инспекции.
Так же в промышленности применяются такие комплексы как:
· Измерительная система ICOS® WI-22xx Wafer Inspector
· Цифровой голографический микроскоп Lyncee Tec R2203
· Оптическая система инспекции поверхности KLA-Tencor Candela
CS20, [29].
.3 Итоговые параметры пластины
После всех технологических операций, у нас имеется подложка со следующими
параметрами, соответствующая 1 квалитету точности:
Таблица 3.3.1 - Числовые значения допусков,[22].
|
Интервал номинальных размеров мм
|
Квалитет
|
|
01
|
0
|
1
|
2
|
3
|
4
|
5
|
|
Св.
|
До
|
мкм
|
|
3
|
0.3
|
0.5
|
0.8
|
1.2
|
2
|
3
|
4
|
|
3
|
6
|
0.4
|
0.6
|
1
|
1.5
|
2.5
|
4
|
5
|
|
6
|
10
|
0.4
|
0.6
|
1
|
1.5
|
2.5
|
4
|
6
|
|
10
|
18
|
0.5
|
0.8
|
1.2
|
2
|
3
|
5
|
8
|
|
18
|
30
|
0.6
|
1
|
1.5
|
2.5
|
4
|
6
|
9
|
|
30
|
50
|
0.6
|
1
|
1.5
|
2.5
|
4
|
7
|
11
|
|
50
|
80
|
0.8
|
1.2
|
2
|
3
|
5
|
8
|
13
|
|
80
|
120
|
1
|
1.5
|
2.5
|
4
|
6
|
10
|
15
|
Таблица 3.2. Параметры готовой подложки
|
№
|
Параметры пластины
|
Значение параметров
|
|
1
|
Диаметр, мм
|
100 ±0,5
|
|
2
|
Толщина, мкм
|
525 ±25
|
|
3
|
Длина базового среза, мм
|
32,5 ±2,5
|
|
4
|
Длина допуска среза, мм
|
18 ±0,5
|
|
5
|
Неплоскостность, мкм
|
7±0,25
|
|
6
|
Непараллельность сторон, мкм
|
13±0,1
|
|
7
|
Прогиб, мкм
|
|
|
8
|
Количество рисок, шт.
|
3
|
|
9
|
Кол-во частиц загрязнения на пластине, шт.
|
10±2
|
|
10
|
Шероховатость рабочей поверхности Rz
|
< 0,05 мкм
|
|
11
|
Отклонение от ориентации, град.
|
±1
|
|
12
|
Дефектность поверхностного слоя
|
Полное отсутствие нарушенного слоя и механических упругих
напряжений. Плотность дислокаций не выше объемной.
|
|
13
|
Глубина нарушенного слоя, мкм
|
1-0,5
|
4. Применение кремния
4.1 Применение кремния в электронике
верхчистый кремний:
· преимущественно используется для производства одиночных
электронных приборов (нелинейные пассивные элементы электрических схем) и
однокристальных микросхем. Чистый кремний, отходы сверхчистого кремния,
очищенный металлургический кремний в виде кристаллического кремния являются
основным сырьевым материалом для солнечной энергетики.
· монокристаллический кремний помимо электроники и солнечной
энергетики используется для изготовления зеркал газовых лазеров.
· соединения металлов с кремнием, силициды являются
широкоупотребляемыми в промышленности (например, электронной и атомной)
материалами с широким спектром полезных химических, электрических и ядерных
свойств (устойчивость к окислению, нейтронам и др.). Силициды ряда элементов
являются важными термоэлектрическими материалами.
Пористый
кремний:
· создание толстых диэлектрических
пленок
· изолирующая основа для структур
«кремний на изоляторе
· буферные слои
· выращивание наноразмерных структур
· создание светоизлучающих приборов
· создание световодов
· создание различных датчиков
· использование в фотодинамической
терапии
На основе подложки, алгоритм изготовления которой мы привели в данной
курсовой работе, изготавливают различными методами множество полупроводниковых
приборов - диоды, транзисторы полевые и биполярные, варисторы, усилители. В
заключение приведем пример одного такого прибора - полевого транзистора.
Оговорим, что сам процесс изготовления прибора на подложке тут не приводится,
поскольку это сложный технологический процесс. Однако отметим, что подобные
приборы изготавливаются при помощи планарной технологии, высокоточной
литографии и иных процессов. Сейчас мы рассмотрим готовый элемент в корпусном
исполнении, его характеристики и область применения.
.2 Полевой транзистор
Полевой транзистор с изолированным затвором - это полевой транзистор,
затвор которого электрически изолирован от проводящего канала полупроводника
слоем диэлектрика. Благодаря этому у транзистора очень высокое входное
сопротивление (у некоторых моделей оно достигает 1017 Ом). Принцип
работы этого типа полевого транзистора, как и полевого транзистора с
управляющим PN-переходом, основан на влиянии внешнего электрического поля на
проводимость прибора, [23].
.2.1 Устройство МДП-транзистора (MOSFET) с индуцированным каналом
На рисунке 4.2.1 показано устройство МДП-транзистора. На основании
(подложке) полупроводника с электропроводностью P-типа (для транзистора с
N-каналом) созданы две зоны с повышенной электропроводностью N+-типа.
Все это покрывается тонким слоем диэлектрика, обычно диоксида кремния SiO2.
Сквозь диэлектрический слой проходят металлические выводы от областей N+-типа,
называемые стоком и истоком. Над диэлектриком находится металлический слой
затвора. Иногда от подложки также идет вывод, который закорачивают с истоком.

Рисунок 4.2.1 - Устройство МДП-транзистора с индуцированным каналом N-типа на кремниевой подложке.
.2.2 Работа МДП-транзистора (MOSFET) с индуцированным каналом N-типа
Подключим напряжение любой полярности между стоком и истоком. В этом
случае электрический ток не пойдет, поскольку между зонами N+
находится область P, не пропускающая электроны. Далее, если подать на затвор
положительное напряжение относительно истока Uзи, возникнет
электрическое поле. Оно будет выталкивать положительные заряды (дырки) из зоны
P в сторону подложки. В результате под затвором концентрация дырок начнет
уменьшаться, и их место займут электроны, притягиваемые положительным
напряжением на затворе. Когда Uзи достигнет своего порогового
значения, концентрация электронов в области затвора превысит концентрацию
дырок. Между стоком и истоком сформируется тонкий канал с электропроводностью
N-типа, по которому пойдет ток Iси. Чем выше напряжение на затворе
транзистора Uзи, тем шире канал и, следовательно, больше сила тока.
Такой режим работы полевого транзистора называется режимом обогащения, [24].

Рисунок 4.2.2 - Принцип работы МДП-транзистора с индуцированным каналом N-типа, на кремниевой подложке.
Принцип работы МДП-транзистора с каналом P-типа такой же, только на
затвор нужно подавать отрицательное напряжение относительно истока, [23].
.2.3 Вольт-амперные характеристики (ВАХ) МДП-транзистора с
индуцированным каналом
.2.4 ВАХ полевого транзистора с изолированным затвором похожи на ВАХ
полевого транзистора с управляющим PN-переходом. Как видно на графике а), вначале
ток Iси растет прямо пропорционально росту напряжения Uси.
Этот участок называют омическая область (действует закон Ома), или область
насыщения (канал транзистора насыщается носителями заряда ). Потом, когда канал
расширяется почти до максимума, ток Iси практически не растет. Этот
участок называют активная область. Когда Uси превышает определенное
пороговое значение (напряжение пробоя PN-перехода), структура полупроводника
разрушается, и транзистор превращается в обычный проводник. Данный процесс невосстановим,
и прибор приходит в негодность, [23].

Рисунок 4.2.3 - Вольт-амперные характеристики (ВАХ) МДП-транзистора с
индуцированным каналом N-типа,
на кремниевой подложке.
.2.5 Главные преимущества полевых транзисторов
· В полевых транзисторах нет инжекции неосновное носителей в
"чужую" область проводимости, как в биполярном. А значит, они
способны работать при сколь угодно малом значении напряжения сток-исток.
Например, 0,3 В. Именно это и позволяет расположить большое количество
транзисторов на один кристалл при разумных значениях потребляемой мощности.
· Так же, у полевых транзисторов значительно выше устойчивость
к излучениям - радиационными, ионным, рентгеновским и пр.
· Благодаря очень высокому входному сопротивлению, цепь полевых
транзисторов расходует крайне мало энергии, так как практически не потребляет
входного тока.
· Усиление по току у полевых транзисторов намного выше, чем у
биполярных транзисторов.
· У полевых транзисторов на порядок выше скорость перехода
между состояниями проводимости и непроводимости тока. Поэтому они могут
работать на более высоких частотах, чем биполярные, [24].
.2.6 Готовый прибор
Готовый прибор в корпусе может выглядеть по-разному. На корпус наносится
маркировка, подтверждающая характеристики транзистора по ГОСТ. Такой транзистор
может быть встроен в микросхему или устройство без дополнительных
технологических операций, то есть представляет собой готовый элемент. На
рисунке 4.2.4 приведен пример корпусного исполнения МДП транзистора, [25].

Рисунок 4.2.4 - Корпусное исполнение МДП-транзистора на кремниевой
подложке
Производители транзисторов применяют два основных типа шифрования - это
цветовая и кодовая маркировки. Маркировка года и месяца изготовления в
соответствии с ГОСТ 25486-82, для обозначения даты используют две буквы или
букву и цифру. Первый символ соответствует году, а второй - месяцу. Такой вид
кодирования применяется не только для транзисторов, но и для других
отечественных полупроводниковых элементов, [26].
На зарубежных приборах дата обозначается четырьмя цифрами, первые две из
которых соответствуют году, а последние - номеру недели, [27].
Европейская система PRO-ELECTRON - код представляет собой символьную
запись. Первая буква означает материал полупроводника: кремний, германий и т.
п. Наиболее распространен кремний, ему соответствует литера В. Следующий символ
- это тип прибора. Далее ставится номер серии продукта. У этого номера
существует несколько диапазонов. Например, если указаны цифры от 100 до 999, то
эти элементы относятся к изделиям общего назначения, а если перед ними ставится
буква (Z10 - А99), то эти транзисторы считаются деталями специального или
промышленного назначения. Кроме того, к общей кодировке может добавляться
дополнительный символ модификации прибора. Ее определяет непосредственно
производитель полупроводниковых элементов.
Американская система JEDEC - использует символьную кодировку, состоящую
из четырех элементов. Первая цифра означает число п-н переходов: 1 - диод; 2 -
транзистор;3 - тиристор; 4 - оптопара. Вторая буква обозначает группу. Третий
знак - это серийный номер элемента (диапазон от 100 до 9999). Четвертый символ
- буква, соответствующая модификации прибора.
Японская система JIS - состоит из символов и содержит в себе пять
элементов. Первая цифра соответствует типу полупроводникового прибора: 0 -
фотодиод или фототранзистор; 1 - диод; 2 - транзистор. Второй элемент - буква
S, она ставится на всех элементах. Следующая буква соответствует типу
транзистора. Последний, пятый, элемент - это модификация прибора (зачастую он
может отсутствовать). Иногда наносится и шестой символ - это дополнительный
индекс (литеры N, M или S), означающий требование соответствия специальным
стандартам. В японской системе цветовая маркировка транзисторов не применяется,
[23].
Область применения полевых транзисторов достаточно обширна - это звуковые
усилители, различные реле, СВЧ - устройства, аналоговые и цифровые микросхемы и
др. МДП-транзистор (MOSFET) с индуцированным каналом - один из самых
перспективных компонентов электронной базы в микроэлектронике.
СПИСОК ИСПОЛЬЗОВАННЫХ ИСТОЧНИКОВ
1. Калюкова
Е.Н. Свойства неметаллов и их соединений: Учебное пособие / Е.Н. Калюкова.-
Ульяновск: УлГТУ, 2002. -112 с.
. Наумченко
А.С. Руководство к лабораторным работам по курсу «Технологические процессы
микроэлектроники»: методическая литература / Наумченко А.С., Светличный А.М.. -
Таганрог: ТРТУ, 2002. -54 с.
3. Яценко О.Б. Основы физики и химии полупроводников, Часть II:
Учебное пособие для вузов / Яценко О.Б., Чудотворцев И.Г., Шаров М.К, -
Издательско-полиграфический центр Воронежского государственного университета,
2007. -50 с.
. Курносов А. И. Технология производства полупроводниковых
приборов и интегральных микросхем, учебное пособие для вузов, издание третье,
переработанное и дополненное / Курносов А. И., Юдин В. В. ,- Москва, Высшая
школа, 1986. -368 с.
. Справочник химика/ Свойства химических элементов/Кремний
[Электронный ресурс] - Режим доступа: http://www.chem100.ru.
6. Большая Энциклопедия Нефти и Газа. Химическое травление кремния. [Электронный ресурс] - Режим доступа:
www.ngpedia.ru/sitemap/00/000.
. Жидкостное химическое травление. [Электронный ресурс] - Режим
доступа: http://www.kazedu.kz/referat/86137.
. Запевалин А.И. Обзор высоко-аспектных процессов травления
кремния // Современная техника и технологии. 2014. № 6 [Электронный ресурс] -
Режим доступа: http://technology.snauka.ru/2014/06/3970.
. Кочетов А.А. Курс лекций по материаловедению в теплоэнергетике
Учебное пособие / [Электронный ресурс] - Режим доступа:
http://twt.mpei.ac.ru/ochkov/TM/index.htm.
. Гуртов, В. А. Физика твердого тела для инженеров: Учеб. Пособие/
Гуртов, В. А., Осауленко, Р. Н, - Москва, 2007. - 300 с. [Электронный ресурс] -
Режим доступа: dssp.petrsu.ru/p/tutorial/ftt/index.htm
. Шелованова Г.Н. Физические основы микроэлектроники, методические
указания / Шелованова Г.Н. , КГТУ, 2003. - 50 с.
. Пилипенко В. А. Физические измерения в микроэлектронике.
Монография / Пилипенко В. А., Пономарь В. Н., Горушко В. А., Солонинко А. А. -
Мн.: БГУ, 2003. - 171 с.
. Смирнов С.В. Методы исследования надежности
наногетероструктурных монолитных интегральных схем, Учебное пособие / Смирнов
С.В. - Томск, ТУСУР, 2010. - 95 с.
. Фаренбрух А. Солнечные элементы: Теория и эксперимент. Учебное
пособие / Фаренбрух А., Бьюб Р. Пер. с англ. под ред. М. М. Колтуна. - М.:
Энергоатомиздат, 1987. -280 с.
. Пат. 2178220 Российская Федерация, H01L21/66, G01R 31/26. Способ
измерения времени жизни носителей заряда в кремнии / Ахметов В.Д; заявитель и
патентообладатель Институт физики полупроводников СО РАН, опубл. 25.02.00.
. Биранский П.И.Полупроводниковая электроника. Справочник /
Биранский П.И., Клочков В.П., Изд. «Наукова думка», Киев, 1957. - 704 с.
. Энциклопедия физики и техники [Электронный ресурс] - Режим
доступа: http://www.femto.com.ua/
. Степаненко И. П. Основы микроэлектроники: Учебное пособие
для вузов. - 2-е изд., перераб. и доп./ Степаненко И. П. - М.:
Лаборатория Базовых Знаний, 2000. - 488 с.
. Персональные страницы. Технологические процессы полупроводникового
производства процессоров. Получение монокристалла и полупроводниковых подложек
[Электронный ресурс] - Режим доступа:
http://people.overclockers.ru/RussOver/13984/Tehnologicheskie_processy_poluprovodnikovogo_proizvodstva_processorov/
. Готра З. Ю. Технология микроэлектронных устройств: Справочник /
Готра З. Ю. - М.: Радио и связь, 1991. - 528 с.
. Прокопьев Е.П. Позитроника ионных кристаллов, полупроводников и
металлов. Монография./ Прокопьев Е.П., Тимошенков С.П., Графутин В.И., Мясищева
Г.Г., Фунтиков Ю.В. - М.: МИЭТ, 1999. - 176 с.
. Дольский А.М. Технология конструкционных материалов: Учебник для
машиностроительных специальностей ВУЗов / Дольский А.М., Арутюнова И.А.,
Барсукова Т.М. и др.; Под ред. Дольского А.М.. - М.: Машиностроение, 2005. -
255 с.
23. Устройство
и принцип работы электронных компонентов [Электронный ресурс] - Режим доступа:
http://hightolow.ru/index.php
24. Радиолюбительский
портал. Справочник. [Электронный ресурс] - Режим доступа:
<http://radiobooka.ru/spravochniki/916-tipy-korpusov-importnyh-tranzistorov-i-tiristorov.html>
. ГОСТ 19095-73
"Транзисторы полевые. Термины, определения и буквенные обозначения
параметров" Введ. 1.01.1975.
. ГОСТ 20398.0-83
"Транзисторы полевые. Общие требования при измерении электрических
параметров" Взамен ГОСТ 20398.0-74 Введ. 01.07.1984.
. ГОСТ 17466-80
"Транзисторы биполярные и полевые. Основные параметры", Взамен ГОСТ
17466-72 Введ. 01.01.1982.
28. Шелованова
Г. Н. Актуальные проблемы современной электроники и наноэлектроники: пособие по
курсовой работе / сост.: Юзова В. А., Шелованова Г. Н.. - Красноярск: ИПК СФУ,
2009.- 124 с.
. Анализ
и инспекция в электронной промышленности. Производство МЭМС [Электронный
ресурс] - Режим доступа: http://imc-systems.ru/category/Proizvodstvo-MEMS/Candela-CS20/
30.